中國粉體網訊 在半導體先進封裝領域,玻璃基板憑借與硅相近的熱膨脹系數、低介電常數等優勢,被視為下一代關鍵材料。而玻璃通孔(TGV)技術作為實現玻璃基板垂直電氣互連的核心工藝,其加工難度一直是行業突破的重點。近日,韓國激光技術公司Laser Apps傳來重磅消息,憑借自主研發的“熔化TGV”技術,成功在1.1毫米厚的玻璃基板上穩定形成通孔,且實現了無微裂紋的高質量加工,為玻璃基板封裝產業開啟了全新篇章。
TGV技術的核心是在玻璃基板上制作數十至數百微米的微米級通孔,再填充銅等金屬完成垂直電氣連接,一塊基板上的孔洞數量甚至可達數萬個。這一工藝對半導體玻璃基板的信號傳輸至關重要,尤其在高頻應用場景中,低介電常數的玻璃基板能有效減少信號損耗。但技術難點也十分突出,玻璃材質脆性高,在加工孔洞時極易產生肉眼難以察覺的微裂紋,這些微裂紋會導致基板在后續加工或使用中破裂,嚴重影響產品良率與可靠性。更關鍵的是,隨著玻璃基板厚度增加,加工難度會呈指數級上升,厚度突破1毫米更是板級封裝行業內的一大技術壁壘。
Laser Apps此次突破正是瞄準了這一難點,其采用的等離子熔化技術,通過等離子弧在玻璃內部精準形成熔化區域實現加工,這項技術不僅能徹底消除微裂紋隱患,還能精準控制孔洞圓度與內壁粗糙度,確保通孔的高質量,為后續金屬填充等工序打下堅實基礎。
事實上,這并非Laser Apps首次在TGV技術領域取得突破。今年5月,該公司就已在0.14毫米厚的玻璃基板上完成50微米大小的TGV孔加工。短短幾個月內,其加工厚度從0.14毫米提升至1.1毫米,近8倍的厚度跨越,充分展現了“熔化TGV”技術強大的可擴展性,也印證了公司在激光加工領域的技術實力。
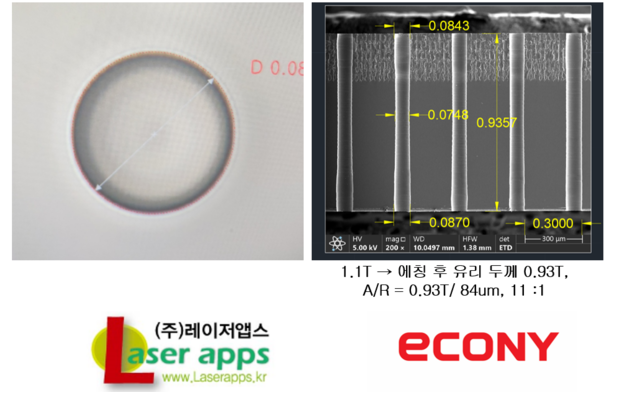
1.1mm厚度玻璃的TGV陣列測量圖像 來源:Laser Apps
從行業價值來看,Laser Apps的技術突破具有重要意義。隨著AI芯片算力需求持續攀升,市場對先進封裝的性能要求不斷提高,玻璃基板封裝憑借在翹曲控制、信號傳輸等方面的優勢,市場規模有望快速增長。在這一背景下,Laser Apps的技術突破不僅為自身發展注入動力,也為全球玻璃基板封裝產業提供了更成熟的技術方案。

來源:Yole,中金公司研究部
目前,Laser Apps已開始為韓國及海外多家半導體玻璃基板廠商提供樣品加工服務,并計劃將TGV技術打造成公司新的增長引擎。未來,隨著技術的進一步成熟與規模化應用,有望推動玻璃基板在先進封裝領域的滲透率加速提升,為下一代高性能芯片的研發與量產提供關鍵支撐,持續助力半導體產業的技術升級。
參考來源:
Laser Apps官網
趙瑾.玻璃基板技術研究進展
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!


















