中國粉體網訊 在后摩爾時代,隨著芯片制程逼近3nm以下物理極限,依賴制程微縮提升性能的邊際效益急劇下降。三維集成技術通過將芯片從二維平面擴展為立體堆疊(“平房”向“高樓大廈”演進),成為延續性能增長的核心方向。在三維集成技術中,鍵合工藝是構建“芯片高樓”的直接核心,也是玻璃基封裝技術的難點和痛點,鍵合技術需同時滿足物理連接強度、電學可靠性及異質材料熱匹配等嚴苛要求。
目前玻璃基鍵合技術已形成多技術路線并行發展的格局,熱壓鍵合、陽極鍵合與超高真空表面活化室溫鍵合是其中的主流方向,各技術在原理、性能與應用場景上各有特點,也面臨不同挑戰。
熱壓鍵合
熱壓擴散鍵合憑借熱物理耦合作用實現界面原子級互擴散,成為玻璃基三維封裝的成熟技術,廣泛應用于MEMS器件、光電器件與微流控芯片封裝。其工藝核心在于高溫與壓力的協同作用,將玻璃基板加熱至400°C-700°C,同時施加壓力,使玻璃表面化學鍵重排,羥基(Si-OH)脫水后形成堅固的Si-O-Si鍵,實現玻璃-玻璃或玻璃-硅的緊密粘接。
不過,熱壓鍵合面臨兩大核心問題:一是不同材料熱膨脹系數不匹配引發的熱應力,易導致封裝器件失效;二是高溫高壓條件對敏感組件的損傷風險。為解決這些問題,業界開發了玻璃熔塊粘合與聚合物鍵合兩種改進方案。玻璃熔塊粘合以低熔點熔塊為中間層,在較低溫度下軟化實現粘接,兼顧鍵合強度與氣密性;聚合物鍵合則利用BCB、PI、PMMA等材料的表面適應性,通過熱壓使聚合物分子與基底形成原子級作用,范德華力可支撐超過40MPa的機械強度。
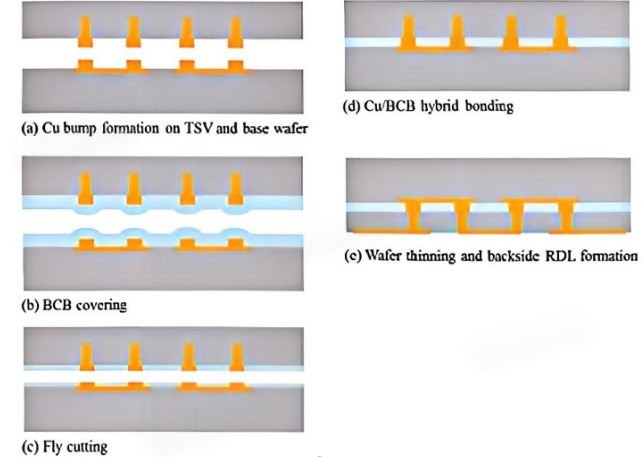
BCB介質與銅互連工藝 來源:Hsiao. Cu/BCB hybrid bonding with TSV for 3D integration by using fly cutting technology
陽極鍵合
陽極鍵合(又稱電場輔助鍵合)由Wallis與Pomerantz于1969年提出,通過熱場與電場協同驅動玻璃中堿金屬離子遷移,實現玻璃與金屬、半導體的原子級鍵合。典型工藝中,玻璃-硅體系在300-500℃下施加500-1500V直流電場,鈉離子(Na+)向陰極遷移形成10-50μm鈉耗盡層,產生超過10MPa的靜電吸引力,同時氧陰離子擴散至硅表面,生成2-5nm非晶態氧化硅過渡層,最終通過Si-O-Si共價鍵實現高強度結合。該技術可完成玻璃與硅、碳化硅、金屬的異質鍵合,但無法直接實現玻璃-玻璃鍵合,需借助中間層突破限制。Cheng等以SiC為共陽極實現玻璃-SiC-玻璃鍵合,獲得約12.8MPa的最大抗拉強度;Koebel等人開發的活化液體錫焊料陽極鍵合(ALTSAB)工藝,通過向錫焊料中添加鋁,顯著提升了鍵合強度。
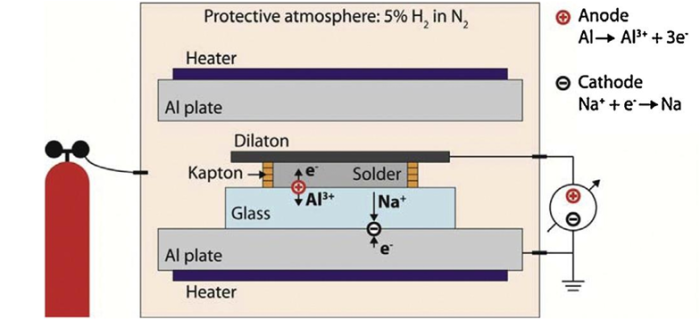
活化液體錫焊料陽極鍵合工藝 來源:Koebel.Optimized solder alloy for glass-to-metal joints by simultaneous soldering and anodic bonding
實際應用中,陽極鍵合面臨三重挑戰:一是金屬離子遷移形成的枝晶結構會引發高頻下的寄生電容與介電性能劣化;二是表面粗糙度導致電場畸變,易誘發微放電與界面分層;三是高溫(>350℃)與高壓電場與CMOS工藝不兼容,可能損傷晶體管柵氧化層。盡管如此,其高氣密性與工藝簡捷性使其在MEMS陀螺儀、硅-玻璃電容壓力傳感器及真空微腔封裝中仍占據不可替代的地位,需通過精確調控電壓與溫度平衡性能與風險。
超高真空表面活化室溫鍵合
為消除傳統熱鍵合的熱應力問題,超高真空表面活化室溫鍵合技術應運而生。該技術是在超高真空環境下,以高能離子束轟擊鍵合表面,剝離污染物、刻蝕氧化層并誘導表層原子化學態重構,暴露高活性亞穩態原子層,室溫下物理接觸即可形成高強度化學鍵合,有效避免熱應力引發的界面失穩。
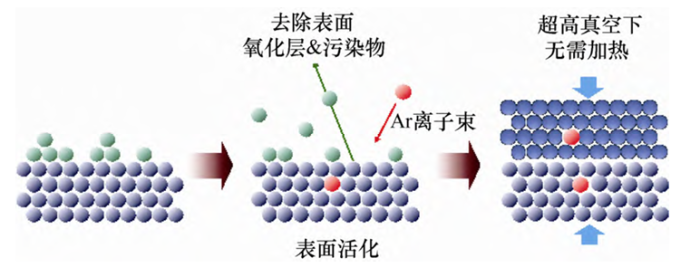
表面活化鍵合機理 來源:《表面活化室溫鍵合技術研究進展》(張洪澤等)
不過,該技術對SiO2表面活化效果不佳,離子轟擊難以激活SiO2表面。針對這一缺陷,業界提出引入納米過渡層的解決方案:通過物理氣相沉積構建納米級中間層,將基板間鍵合轉化為過渡層間的冶金結合。KONDOU研究組的創新工藝極具代表性,其在超高真空環境下原位濺射沉積納米Si(Fe)復合層,同步完成過渡層沉積與表面活化,成功實現SiO2-SiO2異質界面的室溫鍵合,優化后界面強度與單晶硅本體強度相當,為SiO2基材料封裝提供了可行路徑。
綜上,玻璃基鍵合技術各路線均在不斷突破性能瓶頸,熱壓鍵合向低溫化、低應力方向改進,陽極鍵合聚焦工藝兼容性優化,表面活化室溫鍵合則持續拓展適用材料范圍。未來隨著三維封裝對集成密度與可靠性要求的提升,各技術的融合與創新將成為重要發展方向,推動玻璃基鍵合在更廣泛領域的應用。
參考來源:
傅覺鋒.玻璃基低溫激光鍵合技術及垂直互連研究
鐘毅.芯片三維互連技術及異質集成研究進展
張洪澤.表面活化室溫鍵合技術研究進展
Hsiao. Cu/BCB hybrid bonding with TSV for 3D integration by using fly cutting technology
Koebel.Optimized solder alloy for glass-to-metal joints by simultaneous soldering and anodic bonding
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!


















